
SiP与其他封装形式的区别
SiP系统级封装(System in Package),先进封装HDAP(High Density Advanced Package),两者都是当今芯片封装技术的热点,受到整个半导体产业链的高度关注。那么,二者有什么异同点呢?
有人说SiP包含先进封装,也有人说先进封装包含SiP,甚至有人说SiP和先进封装意思等同。
这里,我们首先明确SiP≠先进封装HDAP,两者主要有3点不同:1)关注点不同,2)技术范畴不同, 3)用户群不同。除了这3点不同之外,SiP和HDAP也有很多相同之处,两者在技术范畴上有很大的重叠范围,有些技术既属于SiP也属于先进封装。
1)关注点不同
SiP的关注点在于:系统在封装内的实现,所以系统是其重点关注的对象,和SiP系统级封装对应的为单芯片封装;先进封装的关注点在于:封装技术和工艺的先进性,所以先进性的是其重点关注的对象,和先进封装对应的是传统封装。
SiP是系统级封装,因此SiP至少需要将两颗以上的裸芯片封装在一起,例如将Baseband芯片+RF芯片封装在一起形成SiP,单芯片封装是不能称之为SiP的。先进封装HDAP则不同,可以包含单芯片封装,例如FOWLP (Fan Out Wafter Level Package) 、FIWLP (Fan In Wafter Level Package)。先进封装强调封装技术和工艺的先进性,因此,采用Bond Wire等传统工艺的封装不属于先进封装。此外,有些封装技术既属于SiP也属于HDAP,下图显示的是 i watch采用的SiP技术,因为其封装技术和工艺比较先进,也可以称为先进封装技术。
2)技术范畴不同参考下图,先进封装的技术范畴用橙红色表示,SiP技术范畴用淡绿色表示,两种重叠的部分呈现为橙黄色,位于该区域的技术既属于SiP也属于HDAP。

HDAP和SiP的技术范畴从图中我们可以看出,Flip Chip、集成扇出型封装INFO (Integrated Fan Out) 、2.5D integration、3D integration、Embedded技术既属于HDAP也同样会应用于SiP;单芯片的FIWLP、FOWLP、FOPLP (Fan Out Panel Level Package)属于先进封装,但不属于SiP;
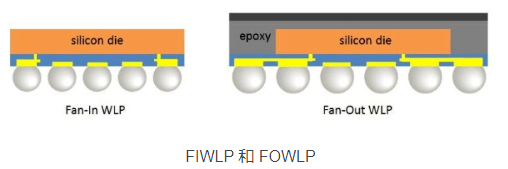
FIWLP 和 FOWLP腔体 Cavity、Bond Wire、2D integration、2D+ integration、4D integration多应用在SiP中,通常不属于先进封装。当然,以上的分类也不是绝对的,只是表明绝大多数情况下的技术范畴。例如,INFO技术属于FOWLP,由于集成了2颗以上的芯片,因此也可以被称为SiP;FliP Chip 属于2D integration,但一般也被认为是先进封装。腔体Cavity技术常用在陶瓷封装的基板设计制造中,通过腔体结构,可以缩短键合线长度,提高其稳定性,属于一种传统封装技术,但也不能排除先进封装中采用Cavity对芯片进行嵌入和埋置。
3)用户群不同对于SiP和先进封装HDAP,从晶圆厂(Foundry)到半导体封测厂(OSAT),再到板级系统电路装配运营商(System user),半导体的整个产业和供应链都涉及在内,但不同的用户群关注点又有所不同。Foundry主要关注先进封装中密度最高,工艺难度最高的部分,例如2.5D integration和3D integration,OSAT关注面比较广泛,从单芯片的WLCSP到复杂的系统级封装SiP都有关注,系统用户System user则对SiP关注较多,参看下图。
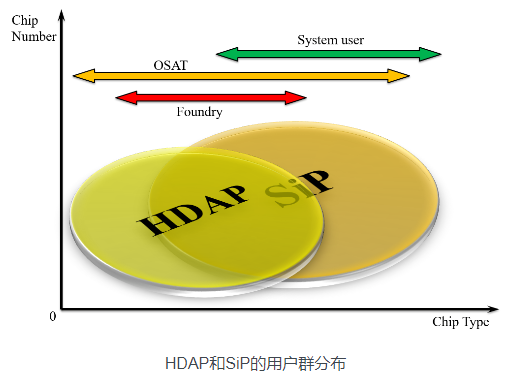
此外,从上图我们也可以看出,虽然HDAP和SiP的芯片数量相当(除了单芯片的WLP),SiP在芯片种类上通常会更多,类别更丰富。
SiP与其他封装形式又有何区别?
SiP与3D、Chiplet的区别
Chiplet可以使用更可靠和更便宜的技术制造,也不需要采用同样的工艺,同时较小的硅片本身也不太容易产生制造缺陷。不同工艺制造的Chiplet可以通过先进封装技术集成在一起。Chiplet 可以看成是一种硬核形式的 IP,但它是以芯片的形式提供的。

3D封装就是将一颗原来需要一次性流片的大芯片,改为若干颗小面积的芯片,然后通过先进的封装工艺,即硅片层面的封装,将这些小面积的芯片组装成一颗大芯片,从而实现大芯片的功能和性能,其中采用的小面积芯片就是Chiplet。
因此,Chiplet可以说是封装中的单元,先进封装是由 Chiplet /Chip组成的,3D是先进封装的工艺手段,SiP则指代的是完成的封装整体。通过3D技术,SiP可以实现更高的系统集成度,在更小的面积内封装更多的芯片。不过,是否采用了先进封装工艺,并不是SiP的关注重点,SiP 关注系统在封装内的实现。
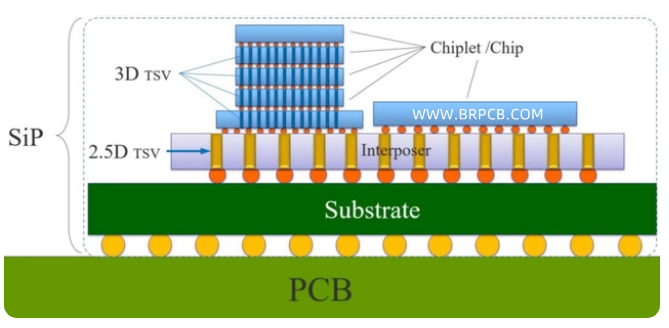
SiP的应用场景
SiP技术是一项先进的系统集成和封装技术,与其它封装技术相比较,SiP技术具有一系列独特的技术优势,满足了当今电子产品更轻、更小和更薄的发展需求,在微电子领域具有广阔的应用市场和发展前景。
通信
SiP在无线通信领域的应用最早,也是应用最为广泛的领域。在无线通讯领域,对于功能传输效率、噪声、体积、重量以及成本等多方面要求越来越高,迫使无线通讯向低成本、便携式、多功能和高性能等方向发展。SiP是理想的解决方案,综合了现有的芯核资源和半导体生产工艺的优势,降低成本,缩短上市时间,同时克服了SOC中诸如工艺兼容、信号混合、噪声干扰、电磁干扰等难度。手机中的射频功放,集成了频功放、功率控制及收发转换开关等功能,完整地在SiP中得到了解决。
汽车
汽车电子是SiP的重要应用场景。汽车电子里的SiP应用正在逐渐增加。以发动机控制单元(ECU)举例,ECU由微处理器(CPU)、存储器(ROM、RAM)、输入/输出接口(I/O)、模数转换器(A/D)以及整形、驱动等大规模集成电路组成。各类型的芯片之间工艺不同,目前较多采用SiP的方式将芯片整合在一起成为完整的控制系统。另外,汽车防抱死系统(ABS)、燃油喷射控制系统、安全气囊电子系统、方向盘控制系统、轮胎低气压报警系统等各个单元,采用SiP的形式也在不断增多。此外,SiP技术在快速增长的车载办公系统和娱乐系统中也获得了成功的应用。
消费电子
目前SiP在电子产品里应用越来越多,尤其是TWS耳机、智能手表、UWB等对小型化要求高的消费电子领域,不过占有比例最大的还是智能手机,占到了70%。因为手机射频系统的不同零部件往往采用不同材料和工艺,包括硅,硅锗和砷化镓以及其他无源元件。目前的技术还不能将这些不同工艺技术制造的零部件集成在一块硅芯片上。但是SiP工艺却可以应用表面贴装技术SMT集成硅和砷化镓芯片,还可以采用嵌入式无源元件,非常经济有效地制成高性能RF系统。光电器件、MEMS等特殊工艺器件的微小化也将大量应用SiP工艺。